您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2024-09-27 15:02
通过一次离子轰击固体材料表面,使二次离子从试样表面发射的方法叫作二次离子质谱(SIMS)法。飞行时间二次离子质谱(ToF-SIMS)法的原理是利用一次离子束溅射固体材料表面,得到二次离子,根据到达检测器的时间推断出二次离子的质荷比,从而得到试样表面的成分信息。ToF-SIMS是一种应用广泛的固体表面分析技术,具有高质量分辨率和高空间分辨率,其检测灵敏度很高,可以检测到痕量级(质量分数约为0.0001%)的杂质。ToF-SIMS会配备溅射离子枪(见图1),使用溅射离子枪可以对试样进行清洁和刻蚀,得到试样深度方向上的成分信息。在使用ToF-SIMS检测试样中的痕量杂质氧时,分析室中残余的氧分子、水分子等会吸附在试样表面,分析离子束撞击试样表面时,其也会被撞击成二次离子,并被检测器检测,导致试样中痕量氧定性分析的误判,从而影响材料和器件制作工艺的改进。
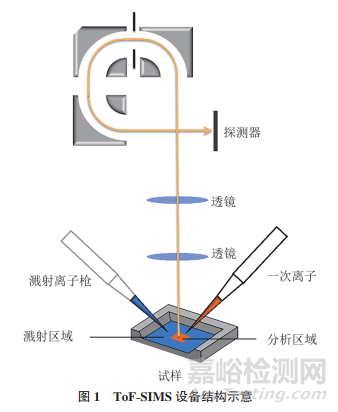
在ToF-SIMS测试中,国内外对于减小分析室中残余气体对氧检测结果干扰的主要方法有:①提高仪器的真空度;②使用ToF-SIMS 中的溅射离子束对表面进行刻蚀,并增大刻蚀速率;③改变离子束光栅的扫描面积。如果要提高仪器真空度,就需要对仪器进行改造,难度较大,且并不能完全排除残余气体对检测结果的干扰。使用ToF-SIMS的溅射离子束对表面进行刻蚀,增大溅射速率会减少残余氧分子和水汽的吸附量,但在溅射离子束转换成分析离子束的过程中,残余气体仍会快速吸附在试样表面,并被检测到。因此,采用方法②也并不能完全排除残余气体的干扰。方法③常用于动态离子质谱仪(D-SIMS)。首先使用离子束进行大面积光栅式扫描,然后在保持离子束束流和分析采样面积(分析面积处于光栅式扫描区域的中心,远小于光栅式扫描面积)恒定的情况下,减小光栅式扫描面积,如将扫描面积减小为原来的1/4,则在离子束束流不变的情况下,溅射速率会增加至原来溅射速率的4倍。在以上情况下,如果氧的离子产额增加了4倍,那么氧元素在试样中恒定存在;如果氧的离子产额增加,但并非4倍关系,说明试样中存在一些氧元素;如果氧的离子产额保持不变,说明检测到的氧元素来自于残余的氧分子和水汽。D-SIMS深度剖析的溅射离子束与分析离子束为同一离子束,其束流远大于ToF-SIMS分析离子束的束流,不需要切换离子束,因此方法③不适用于ToF-SIMS。
研究人员提出了一种新的判定痕量氧元素的方法,通过改变分析离子束的光阑大小,进而改变作用于试样表面单位面积的束流大小,通过比对不同离子束流下产生的氧离子计数,判定痕量氧元素是否存在。
1、 试验材料及方法
1.1 试验材料
CaF2是一种非常重要的传统晶体材料,其具有紫外透过率高、透光范围宽(0.125~10µm)、折射率低、激光诱导损伤阈值高、熔点低、化学性质比较稳定等优点,在紫外光刻、天文观测和高分辨率成像等领域中应用广泛。氧元素是CaF2中最主要的杂质之一,杂质元素氧的存在会导致CaF2中形成色心,降低其在紫外波段的透过率和抗激光辐照性能。YF3在0.35~12µm的光谱范围内有着良好的光学传输性,是一种常用的低折射率薄膜材料,广泛应用于紫外、红外波段的高反射镜、分光镜、薄膜干涉滤光片等。传统的热蒸发或者电子束沉积工艺制备的薄膜会出现氟缺失、氧污染等缺陷。Au的化学性质较稳定、不易氧化,广泛用于制作真空紫外反射膜、红外激光高反镜、脉宽压缩光栅等。因此,试验时选用双面抛光CaF2晶体、YF3薄膜、纯度为99.99%的Au镀制的Au膜作为分析试样。
1.2 试验方法
通过测试时设置分析Bi离子源使用的光阑大小,改变Bi离子束的离子束流,进而改变作用于试样表面单位面积的离子剂量。试验选用Bi离子枪的光阑大小为100µm和200µm。相比于100µm光阑下的Bi离子束,200µm光阑下的Bi离子束的束流、单位面积离子剂量更大,在作用时间和作用面积不变的情况下,撞击试样的Bi离子更多,使得试样中元素二次离子的产额增加。由于作用面积不变,吸附在试样表面残余气体的二次离子产额不会改变(见图2)。
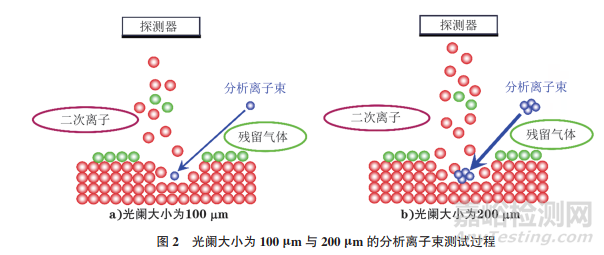
改变分析离子源(Bi离子源)的光阑大小可以改变分析离子束流,对比不同分析离子束流下氧的二次离子产额。如果光阑为200µm时测得的氧离子产额大于光阑为100µm时测得的氧离子产额,则试样中存在氧元素;如果光阑为200µm时和光阑为100µm时测得的氧离子产额没有明显差异,则试样中不存在痕量氧元素,测得的氧元素来自于吸附的残余氧分子、水分子。
对CaF2晶体、YF3薄膜和Au膜进行ToF-SIMS测试,测试时的真空度为5×10-6Pa。采用能量为1keV的Ar离子作为溅射离子束,离子束电流为 100 nA,用于刻蚀材料表面,实现深度剖面分析,溅射离子束的溅射面积为400µm×400µm(长度×宽度)。采用能量为30keV的Bi2+作为分析离子束,分析离子束的分析时间约为0.13min。ToF-SIMS对氧离子的采集均采用负离子采集模式。Bi离子源的参数如表1所示。
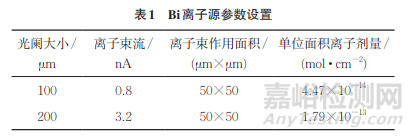
2、 试验结果与讨论
不同Bi离子源光阑下CaF2晶体的深度剖析曲线如图3所示。由图3可知:当Bi离子源光阑大小由100µm变为200µm后,氟元素的二次离子产额增加1.2倍,氧元素的离子产额增加3.2倍,说明CaF2晶体中存在氧元素。
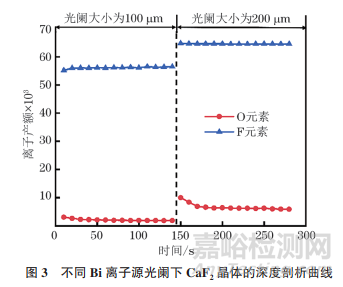
CaF2的紫外透过率光谱如图4所示。由图4可知:晶体中氧浓度与197nm处的吸收系数呈线性关系,测试光谱在185~210nm处有吸收峰,表明CaF2晶体中存在杂质氧,且氧元素的质量分数小于0.0001%。

不同Bi离子源光阑下YF3薄膜的深度剖析曲线如图5所示。由图5可知:当Bi 离子源光阑大小由100µm变为200µm后,氟元素的二次离子产额增加1.4 倍,氧元素的二次离子产额增加2.2 倍,说明YF3薄膜中存在氧元素。
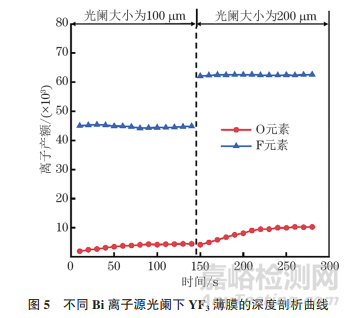
YF3薄膜的红外透过率光谱如图6所示,可见YF3薄膜在2.9µm和6.1µm处有O—H键拉伸振动峰,说明试样中存在氧元素。
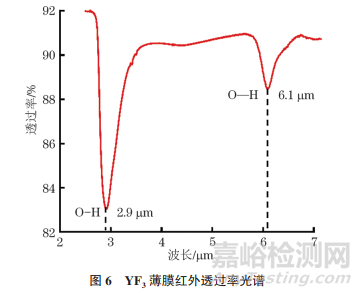
Au膜的ToF-SIMS质谱图如图7所示,谱图中可见氧元素的特征峰。不同Bi离子源光阑下Au膜的深度剖析曲线如图8所示。由图8可知:在Bi离子源光阑大小由100µm变为200µm后,金元素的二次离子产额增加1.4倍,氧元素的离子产额并未增加,说明Au膜中没有氧元素,检测到的氧元素来自试验环境中残余的氧分子和水分子。

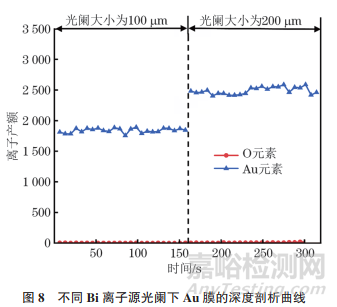
3、 结论
采用改变分析离子源光阑大小的方法改变离子束流,进而改变作用在试样表面的单位面积离子剂量,对CaF2晶体、YF3 薄膜、Au膜进行ToF-SIMS测试。当离子束流增大时,CaF2晶体与YF3薄膜的氟离子、氧离子产额均增加,表明CaF2晶体与YF3薄膜中存在氧元素,测试结果与CaF2 的紫外光谱测试结果和YF3薄膜的红外光谱测试结果相吻合。当离子束流增大时,金离子产额增加,而氧离子产额无明显变化,说明检测到的氧元素来自试验环境中的残余气体,Au膜中不存在氧元素。采用改变分析离子源光阑大小的方法改变分析离子束流,对比不同离子束流下痕量氧离子的产额变化,可以准确地判定试样中痕量氧元素是否存在。
作者:冯殿福 1,崔云 2,陶春先1,杨峰3,侯瑶1
单位:1. 上海理工大学 光电信息与计算机工程学院;
2.中国科学院 上海光学精密机械研究所 薄膜光学实验室;
3. 中国科学院 理化技术研究所 功能晶体与激光技术重点实验室。
来源:《理化检验-物理分册》2024年第7期

来源:理化检验物理分册


