您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2025-03-27 08:38
二次离子质谱法(Secondary Ion Mass Spectrometry, SIMS)是一种通过向样品表面照射高能离子束,分析由此产生的二次离子,从而实现元素定量分析和深度剖析的技术。离子轰击下固体表面的二次离子发射提供了有关其最上面的原子层的元素、同位素和分子组成的信息。根据化学环境和溅射条件(离子、能量、角度),二次离子产生率会有很大的变化。这会增加该技术的量化方面的复杂性。
工作原理
在SIMS中,高能离子束照射样品表面,引发溅射效应,从而产生二次离子。这些二次离子被质量分析器接收并分析,以实现元素的定性和定量分析。

离子生成机制
中性粒子:约占99%以上的溅射粒子,不带电荷。
二次离子:带电的溅射粒子,是SIMS的分析目标。
电子:由高能离子束激发,释放到真空中的电子。
特点与优势
广谱适用性:几乎适用于所有元素的分析。
高灵敏度:能够检测到微量元素(ppb至ppt级别)。
深度剖析能力:可进行样品深度方向上的元素分布分析。
应用
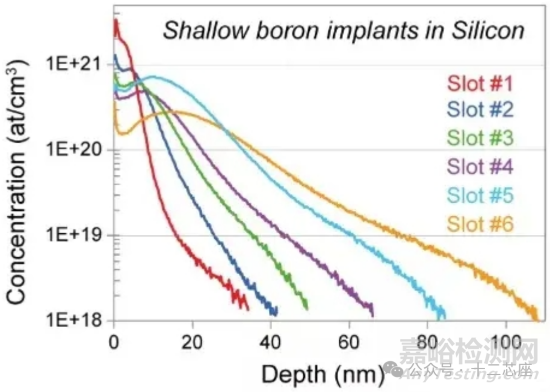
1. 异种材料界面位置的确定
在半导体材料中,例如AlGaAs/GaAs样品,通过SIMS分析可以确定界面位置。
2. Si中的杂质浓度评估
通过SIMS对Si晶圆进行深度方向分析,可以评估杂质浓度。包括Si中的B, C, O和 N元素。
3. 浅注入和超薄膜的超高分辨率深度分析
结论
二次离子质谱法(SIMS)因其广谱适用性、高灵敏度和深度剖析能力,在半导体领域应用广泛。尤其在异种材料界面分析和杂质浓度评估方面具有重要价值,能够检测implant的注入深度,使其成为器件研发和仿真的关键手段。

来源:Internet


