您当前的位置:检测资讯 > 科研开发
嘉峪检测网 2024-10-06 09:30
下图是非气密性封装的资质验证项:

表中SBS、BPS、BS、SD、WSR等均为产品验证过程中的品质验证项,而PC、HTSL、THB、HAST、TC、UHAST、AC等则为可靠性验证项。我们大致把这几个可靠性验证项过一下。
PC:Precondition(JESD22-A113)
Precondition也就是我们常说的预处理,非气密性器件在长期存储过程中内部会被水汽侵入,而这些水汽在器件上板经历回流焊时由于高温,水汽迅速膨胀,则可能会造成不同材质界面分层而产生应力导致产品失效。预处理则是通过模拟产品从工厂出货至上板前所经历的各环节,来考核器件对所处环境的潮湿敏感等级,也就是我们常说的MSL。其流程如下:

Step1:电气测试,确保用来考核可靠性的产品均是良品。
Step2:外观检测与SAT扫描,为考核前后失效判断做参考。
Step3:温度循环测试,文中给出的条件是-40℃~60℃测试5个循环,本项主要是模拟产品在运输过程中所经历的高低温变化。测试条件可根据不同的运输环境按照JESD22-A104进行选择。实际操作中,传统塑封类产品大家多用-65℃~150℃这个极致条件进行5个循环的测试。
Step4:烘烤,本项主要是去除外包装上的水分。
Step5:潮湿敏感等级(MSL)测试,用于评估器件从防潮袋取出后到上板安装前,在不同温湿度环境下的可存储时间(Floor Life),下图给出了不同测试条件下的Floor Life以及其储存温度。

Step6:回流焊*3次,分别为首次安装时经历的回流考核,板子存在异常,更换异常器件时的拆、卸对其造成的2次回流焊考核。
Step7~9:均为可选项,目前也没人做这几项,我们也就不要给自己增加学习压力了。
Step10:外观检测以及分层扫描,对比实验前后,产品外观、分层方面的变化,分层变化标准在J-STD-020F中有做出详细介绍。
Step11:电气测试,判断试验后产品电气性能是否正常。
HTSL:High Temperature Storage Life(JESD22-A103/113)
高温存储寿命,考核器件在存储过程中高温条件下热激活失效机制对寿命的影响,封装常见的失效为肯达尔效应(Kirkendall),即两种不同物质(比如金球与铝焊盘)在长期使用或存储过程中分子相互扩散而形成的空洞。
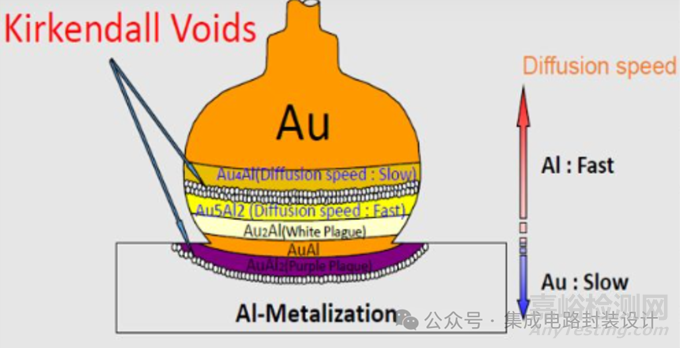
TC:Temperature Cycling(JESD22-A104)
高低温循环实验,与预处理中讲的一样,预处理后的高低温循环主要用于模拟考核产品在装配、使用过程中外界温度以及产品开关引起的温度急剧变化产生的应力影响。实验条件取决于产品实际装配、应用过程中的温度,传统塑封类产品大家多用-65℃~150℃这个极致条件进行考核。

THB、HAST、UHAST、AC
这几项均是利用高温、高湿等手段加速考核非气密性器件在潮湿环境中的可靠性。
THB:Temperature Humidity Bias稳态温湿偏置寿命实验,实验条件为85℃、85%RH、Vcc Max、1000h,也就是我们常说的双85实验。
HAST:Highly Accelerated Temperature and Humidity Stress Test高温湿度加速应力测试,实验条件为130℃、85%RH、Vcc max、96h或110℃、85%RH、Vcc max、264h;因为验证过程加了偏置电压,因此通常也称为BHAST。
UHAST:Unbiased HAST无偏压的高温湿度加速应力测试,实验条件同BHAST一致,只是去掉了偏压,其目的是发现被偏压掩盖掉的失效机制,例如电偶腐蚀。
AC:Accelerated Moisture Resistance-Unbiased Autoclave不加偏置的高压加速防潮测试,翻译很绕口,其实就是我们常说的高压蒸煮实验PCT,实验条件121℃、100%RH、96h,文中指本实验不适用于基于层压板或胶带的封装(例如FR4以及聚酰亚胺胶带),因此适用范围有限。
JESD47文件中指出THB、BHAST、UHAST、AC只需选择一个即可(见下图),由于THB实验时间长达1000h,AC适用范围受限,因此通常选择BHAST或UHAST来加速考核器件在潮湿环境中的可靠性。而UHAST更能体现被偏置电压掩盖掉的失效机制,相对更适用于考核封装的可靠性,BHAST相对更适用于考核器件可靠性,因此封装常做的是UHAST实验。

塑封类IC器件封装可靠性验证流程
JESD47中介绍TC、THB、BHAST、AC、UHAST需要在PC之后进行,下图为塑封类IC器件的封装可靠性验证流程,供大家参考。


来源:集成电路封装设计


